
一高速和高精度倒装芯片键合机YSB55w特性
- 传统机器的高粘接精度和 x3 生产率!
这为不断扩大的倒装芯片市场带来了半导体封装的新时代。 - 高速 8 模具同时拾取和同步传输实现 13,000 UPH
- 通过2个翻转头并行处理实现高速拾取。
- 每个翻盖头单元配备 2 个供应单元。在不浪费时间的情况下为倒装芯片供电!
- 无需工具/技能即可设置助焊剂厚度,大大节省了产品更换时间。
- 自动喷嘴更换器可处理 □2 至 30 毫米的切屑尺寸范围,从而最大限度地减少产品更换时间。
- 高精度 ±5μm (3σ)
- 高质量和灵活性
二规格参数
| YSB55w系列 | |||
|---|---|---|---|
| 适用基材 | 长 240 x 宽 200 至 长 50 x 宽 50mm | ||
| 基板厚度 | 0.2 至 3.0mm | ||
| 运输方向 | 从左到右(选项:从右到左) | ||
| 粘接精度 | ±5μm(3σ)(使用雅马哈标准组件时) | ||
| 吞吐量 | 13,000UPH (包括处理时间) | ||
| 适用晶圆尺寸 | 12寸晶圆 | ||
| 适用芯片尺寸 | □2 至 30mm | ||
| 电源 | 三相交流 200/208/220/240/380/400/416V ±10% 50/60Hz | ||
| 送风 | 0.45MPa以上 | ||
| 外形尺寸 | L2,090 x D1,866 x H1,550mm(YSB55w主机和晶圆进料单元) | ||
| 重量 | 约3,600kg(YSB55w主机和晶圆进料单元) | ||
规格和外观如有更改,恕不另行通知。







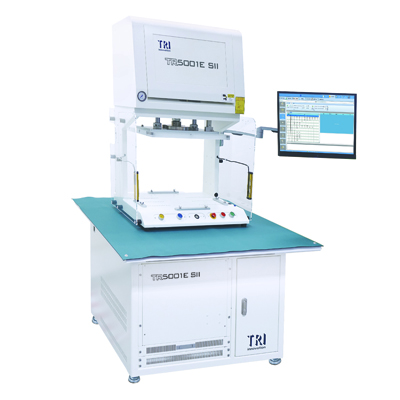
评论