混合型 SIPLACE CA2 高速平台革新了 SIP 的生产
一台设备完成晶圆与SMT元件的组装
新型 SIPLACE CA2 是 SMT 贴片机与固晶机相结合的混合贴片机,它可以在同一个工序中处理供料器供应的 SMD 以及直接取自切割好的晶圆上的芯片。SIPLACE CA2 通过将复杂的固晶工艺集成到 SMT 生产线,不再需要使用特殊机器,减少了重复投资。
电子产品持续微型化和复杂化,系统级封装是先进封装类的一种,它将 IC 和SMT 元器件组合在一个高度创新的紧凑系统中。如何应对新的工艺所面对的制造工艺挑战,SIPLACE CA2已经做好准备,帮助您建立先进封装流程。
完美匹配集成化智慧工厂
新型混合平台使半导体领域能够获得 SIPLACE 贴片解决方案的市场领先的软件和质量控制功能:安全而全面的芯片贴装工艺的可追溯性,最大的编程灵活性以及快速而简单的产品切换。借助众多标准化接口,SIPLACE
CA2 确保了 M2M 和 M2H 的连续通信,并且可以无缝融入 ASMPT 的开放式自动化理念中。
一台机器可处理两种工艺Two processes completed on one machine
一台机器实现高速晶圆来料芯片组装和SMT贴装
主要特点
◆最高生产力
通过芯片键合工艺和倒装芯片工艺,在同一工序中处理 SMT 元件和直接取自晶圆的芯片。
◆节约成本
无需料带,从而也不会产生废料。无需投资特殊机械设备。
◆独一无二的灵活性
晶圆系统可处理 50 种不同的晶圆,晶圆更换时间不到 6 秒(“ 全面的多种裸芯片处理能力 ”)。如果不用晶圆系统,可使用卷装料的料车(COT)和用于 JEDEC 制式料盘的 tray 盘供料器。全面的可追溯性全面的可追溯性对每块裸芯片从晶圆上的位置到其在电路板上的贴装位置进行数据追踪,(“ 全面的单独裸芯片级追踪能力 ”)
◆始终如一的可持续性
处理直接取自晶圆的芯片,无需编带,不会产生大量的废料带。
◆最佳性能
得益于芯片缓冲和并行处理功能,SIPLACE CA 每小时能够贴装多达50,000 元器件,其精度高达 10 µm @ 3 σ。
◆全面的质量管理
多种高端图像处理系统能够可靠识别最小的元器件和元件,从而实现全面的工艺控制。
CP20头
▪ 元器件范围:公制 0201 元器件至8.2 mm × 8.2 mm × 4 mm
▪ 最小贴装压力:0.5 N
▪ 极快速度:高达 48,000 cph
▪ 极高精度:高达 ±10 µm @ 3 σ
晶圆更换装置
▪ 极度灵活:可处理 50 种不同的晶圆
▪ 极快速度:晶圆切换仅需 5.6 秒
▪ 支持4寸-12寸晶圆
▪ 同时支持正装与倒装芯片贴装工艺
规格参数
贴装速度(标称值)SMT up to 75,000 Cph
贴装速度(标称值)从晶圆上贴装倒装芯片 up to 40,000 Cph
贴装速度(标称值)从晶圆上贴装芯片 up to 50,000 Cph
贴装精度( 3σ )20µm / 15µm / 10µm(可根据元器件等级选择)
外形尺寸2560 × 2500 m × 1850 mm (长 × 宽 × 高)
料位多达 80 个 8 mm 供料器 or 2 个多晶系统以及 10 个 8 mm 供料器
功耗(平均)1.9 kW





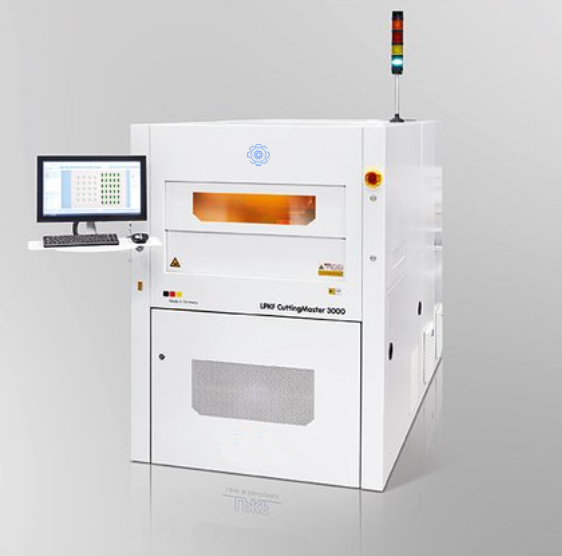



评论